FEI Helios FIB SEM
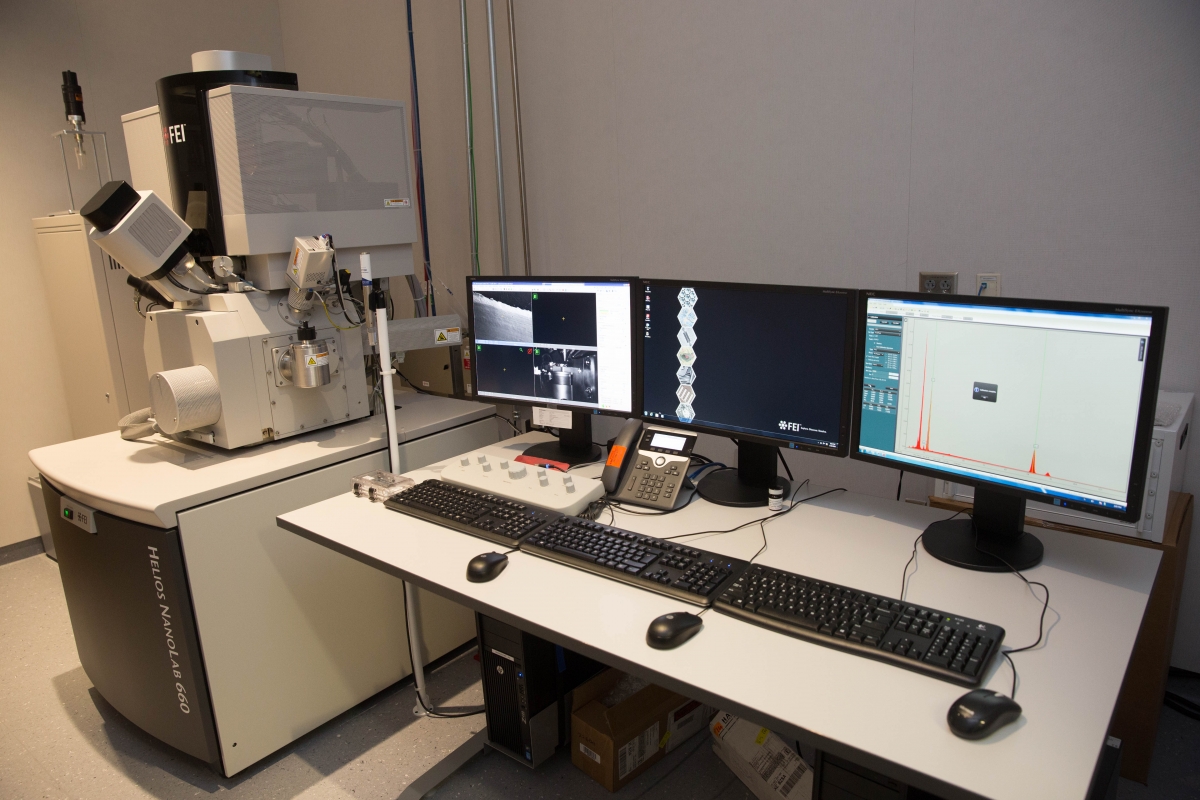 The FEI Helios NanoLab 660 DualBeam is a fully digital, Extreme High Resolution (XHR) Field Emission Scanning Electron Microscope (FE SEM) equipped with Focused Ion Beam (FIB) technology. It allows for fast characterization of nanometer details and analysis in 2D and 3D, high quality thin sample preparation for TEM and flexible nanoprototyping.
The FEI Helios NanoLab 660 DualBeam is a fully digital, Extreme High Resolution (XHR) Field Emission Scanning Electron Microscope (FE SEM) equipped with Focused Ion Beam (FIB) technology. It allows for fast characterization of nanometer details and analysis in 2D and 3D, high quality thin sample preparation for TEM and flexible nanoprototyping.
The FIB SEM can be used for nanofabrication as well as 3-D reconstruction of biological structures.
- Schottky field emitter electron source for landing energies 20 V - 30 kV
- Gallium ion source
- Everhart-Thornley detector for conventional SE detection
- Through-the-lens detector (TLD), collecting SE and high-loss BSE, specially designed for high-resolution imaging at both high and low kV's
- The MD mirror detector is designed for excellent contrast of materials at landing energies down to 500 eV
- GIS: W, Pt, insulator deposition and etching
- EDAX Octane Pro detector for elemental analysis

